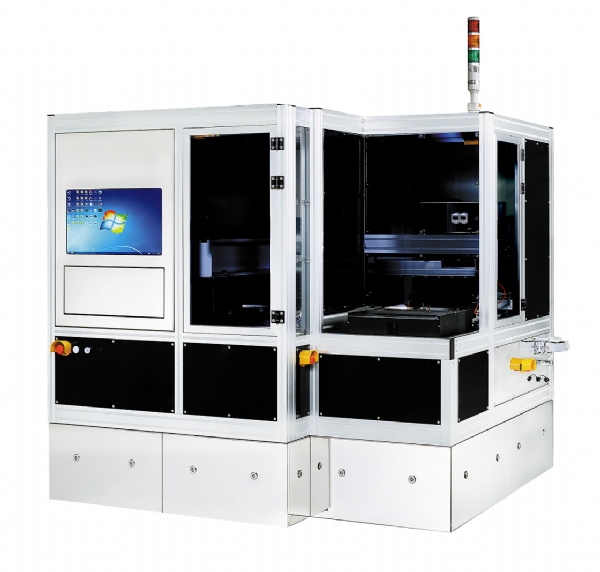
亞亞科技晶圓紅外線檢查機,針對切割道檢查,封裝廠多用來進行晶圓切割(die saw)後的隱崩檢測。
消費性電子產品輕薄化與多功能化已經是市場趨勢,因此IC封裝廠在進行薄型化製程時,就必須克服應力或切割所產生的晶片邊緣崩裂(Edge Chipping),晶片正面崩裂(Front side chipping)及晶片背面崩裂(Back side chipping)等難題。而背面崩裂,或晶片內層崩裂因無法用肉眼判斷,稱之為隱崩。
亞亞科技針對晶圓切割後隱崩做檢測,全自動的IR檢查系統,可搭配自動上下料模組,針對整面晶圓做檢測; 軟體具備wafer mapping,及自動判斷功能,可記錄缺陷位置,輸出缺陷影像及統計資訊,提供封裝廠切割後品質管控方案。亞亞晶圓紅外線檢查機無需移除Dicing tape或取下單一die,即可全面檢測,也同時適用於8” 及12” 晶圓。